
Precision casting with excellent quality
Integrated research and development, manufacturing, sales, and technical services of laboratory scientific instruments and intelligent equipment
National Consultation Hotline 15738867410

Integrated research and development, manufacturing, sales, and technical services of laboratory scientific instruments and intelligent equipment
National Consultation Hotline 15738867410
15738867410
Greenland Binhu International City (District 1), Erqi District, Zhengzhou City, Henan Province
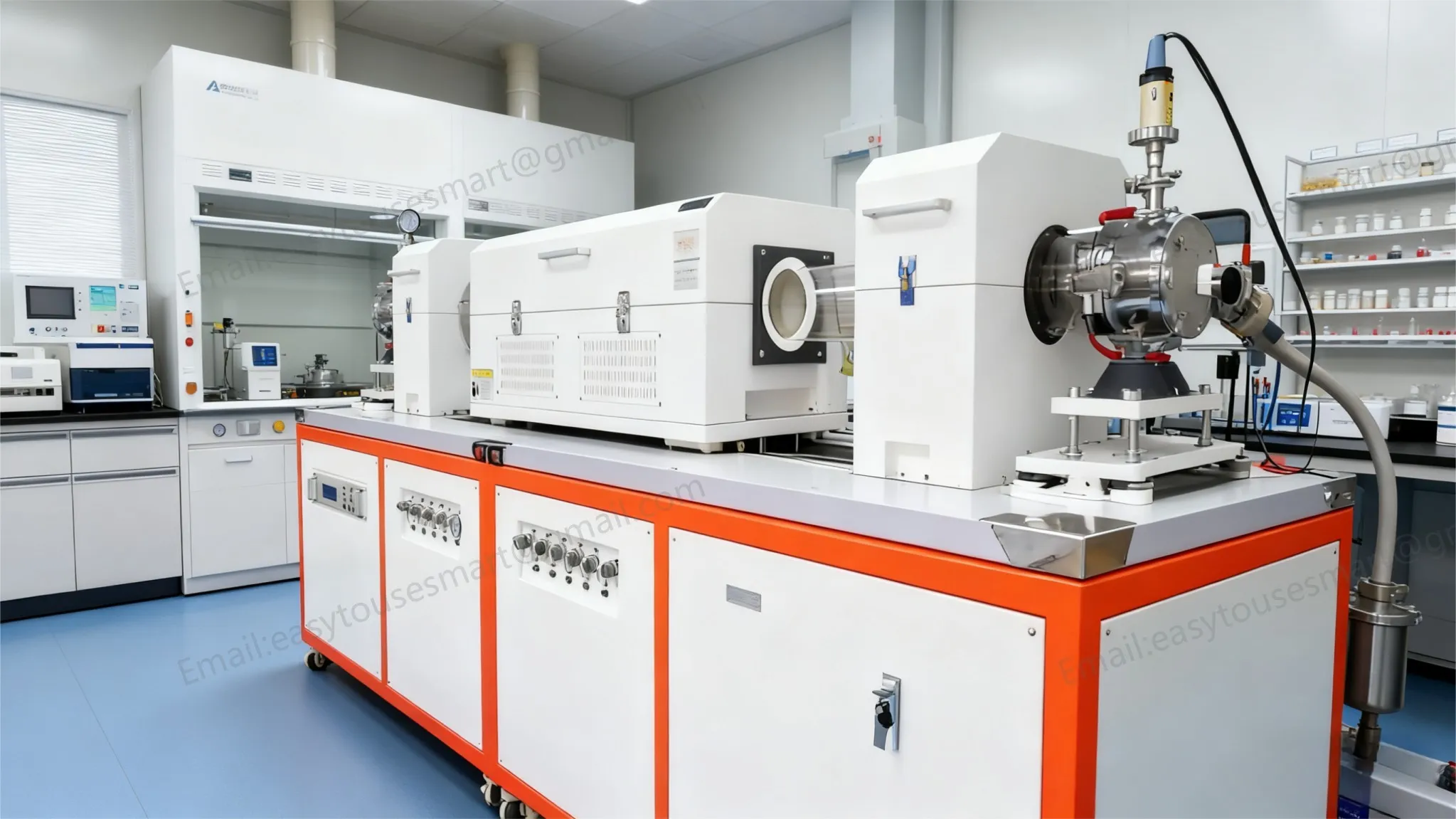
Details

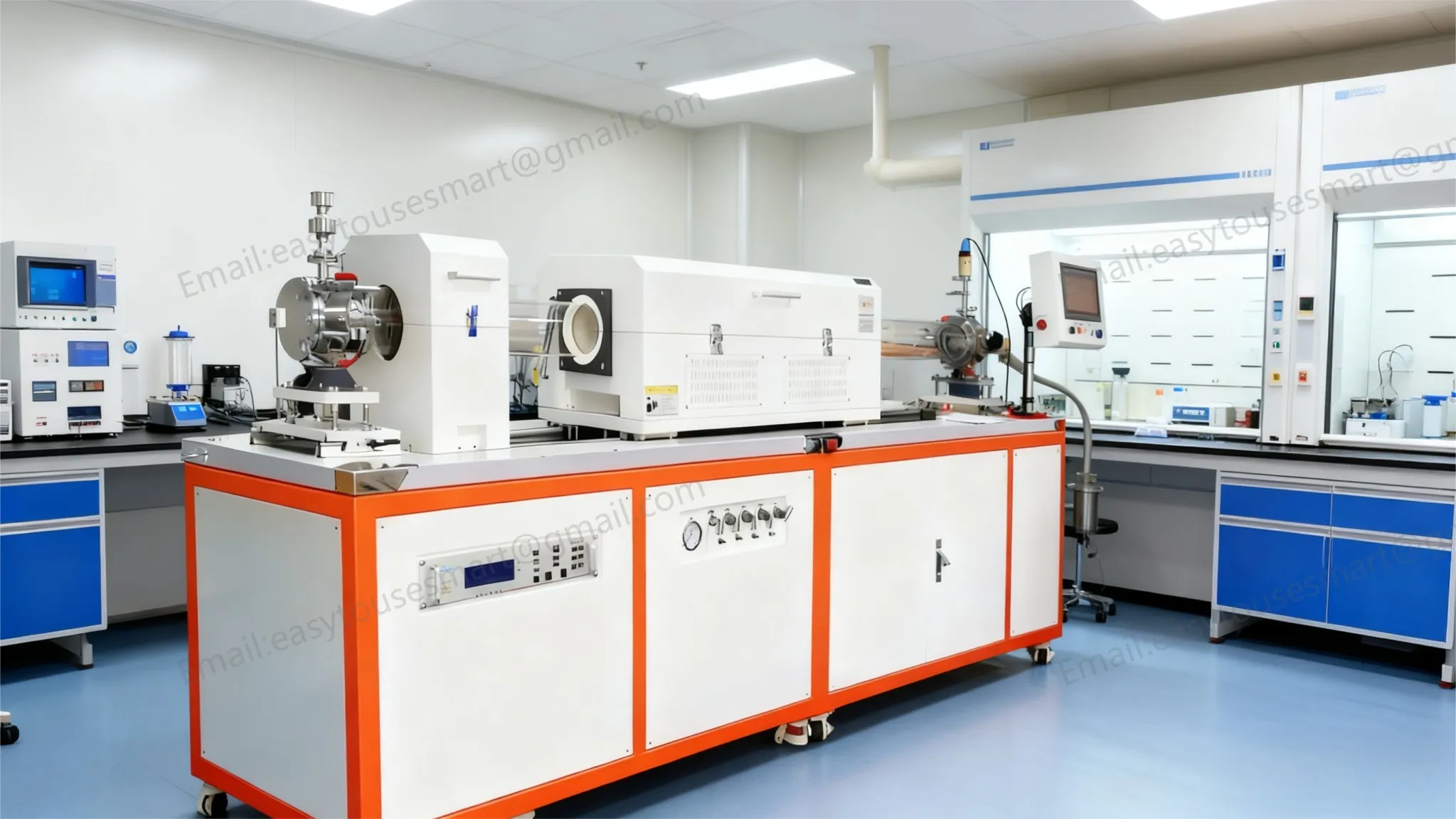
This PECVD system integrates high-temperature heating and RF plasma enhancement for thin film research. It supports substrate heating up to 1200℃ and low-temperature plasma deposition, suitable for graphene, DLC, silicon-based films, insulating layers and optical coatings. Widely used in university and institutional labs for photovoltaic, semiconductor, MEMS and surface engineering research.
RF Plasma & High-Temperature Heating
13.56 MHz RF unit (0–300W/500W) with automatic impedance matching. Stable plasma enables deposition at 400–600℃. Silicon carbide heaters allow max 1200℃; selectable thermal CVD, PECVD or combined modes.
Precision Temperature Control
Single/dual-zone PID control (±1℃). Supports 30+ segmented temperature profiles with programmable ramp/hold/cooling and plasma sequence control. Real-time data logging for repeatability.
Multi-Channel Gas Delivery
4–8 gas lines with imported MFCs (±1% F.S.). Accurate mixing of process and carrier gases. Pre-mixing chamber and bypass exhaust stabilize chamber pressure during switching.
Vacuum & Pressure Control
Compatible with atmospheric and low-pressure PECVD. Standard ultimate vacuum ≤5×10⁻³ Pa; upgradable to 1×10⁻⁵ Pa with molecular pump. High-precision gauge and electric valve for closed-loop pressure regulation.
Control & Safety
PLC + 10-inch touchscreen. Displays temperature, vacuum, flow, RF power. Stores recipes, supports data export. Safety interlocks: over-temperature, water flow, overcurrent, RF reflection, emergency stop and gas alarm.
Item | Specification |
Model | Smart-PECVD-1200 |
Heating Element | High-purity silicon carbide rod |
Temperature Zones | Single / dual (optional) |
Max Temperature | 1200℃; stable ≤1150℃ |
Constant Zone Length | ≥300mm (single zone) |
Temperature Accuracy | ±1℃ |
Ramp Rate | 0.1–20°C/min, programmable |
RF Frequency | 13.56 MHz |
RF Power | 0–300W / 0–500W (adjustable) |
Matching | Automatic impedance matching |
Reaction Chamber | High-purity quartz tube, Φ60/80/100 mm × 1000–1200 mm |
Gas Channels | 4/6/8 (expandable) |
Flow Control | Imported MFC, 0–10 to 0–500 SCCM |
Ultimate Vacuum | ≤5×10⁻³ Pa (standard); ≤1×10⁻⁵ Pa (upgrade) |
Pressure Control | Electric butterfly valve + PID |
Cooling | Air cooling / water-cooled flange & electrode |
Control | 10-inch touchscreen + PLC |
Power | AC 380V, 50Hz, 8–12kW |
Graphene preparation
DLC coating deposition
Amorphous/microcrystalline silicon films
Silicon nitride/silicon oxide dielectric layers
Carbon nanotube arrays
Optical anti-reflective and reflective coatings
This system combines high-temperature process stability with plasma-enhanced deposition. It supports flexible process modes, precise parameter control and reliable safety design. Suitable for research labs working on new energy, semiconductor materials and surface coatings.
QR code

Contact information
15738867410
Online Message
Top